بازده کندوپاش
کندوپاش توسط یونهای پرانرژی که یک ماده منبع را به عنوان هدف در پلاسما بمباران میکنند صورت میگیرد. نسبت کنده شدن اتمها از هدف به ازای هر یون فرودی از پلاسما به عنوان بازده کندوپاش شناخته میشود. بازده کندوپاش به پارامترهای متعددی از محفظه کندوپاش مانند فشار و یا ترکیب مواد هدف بستگی دارد و یک عامل کلیدی در فرآیند لایهنشانی کندوپاشی است.
بازده کندوپاش چیست؟
ایجاد لایههای نازک از مواد مختلف توسط کندوپاش DC یا RF یک روش پوششدهی شناخته شده است که به طور گسترده در لایهنشانی پوششهای سخت، نیمههادیهای لایه نازک، ساخت سلولهای خورشیدی، آمادهسازی نمونههای SEM و غیره استفاده میشود. راندمان پوششدهی کندوپاشی به شدت به بازده کندوپاش ماده هدف، یعنی نسبت اتمهای کنده شده از سطح هدف به ازای هر یون پرانرژی پلاسما، بستگی دارد. این اتمهای کنده شده متعاقبا بر روی بستر لایهنشانی میشوند و سرعت رشد لایه بر حسب ضخامت ایجاد شده در ثانیه محاسبه میشود.
بازده کندوپاش S معمولاً به عنوان میانگین تعداد اتمهایی که از سطح هدف به ازای هر یون برخورد کننده کنده میشوند فرموله میشود:
S = تعداد اتمهای کنده شده از هدف / تعداد یونهای برخورد کننده به هدف
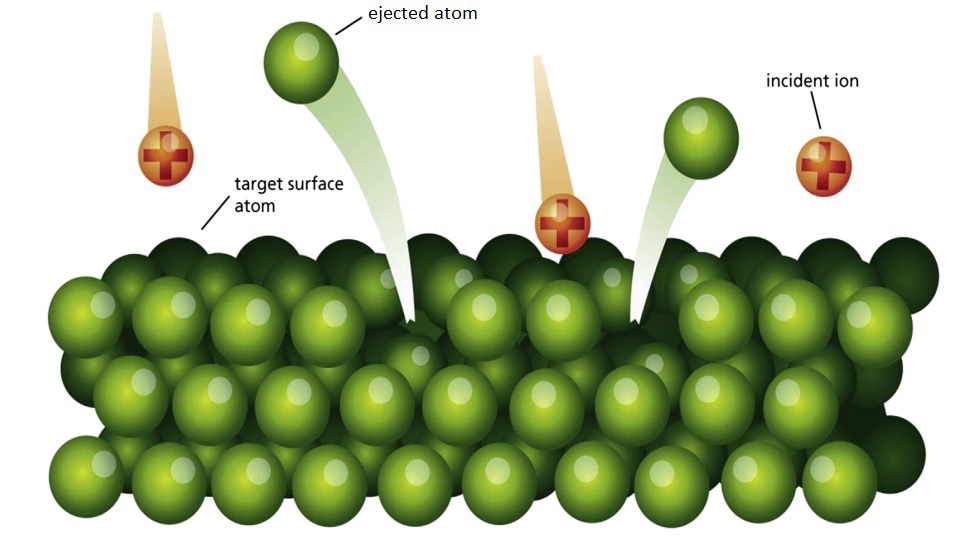
بازده کندوپاش یا نرخ کندوپاش؟
نرخ کند و پاش معمولا به عنوان ضرب بازده کندوپاش در جریان یونی هدف مطرح میشود. بنابراین به کاربردن این دو مفهوم در جای یکدیگر امری متداول است و از این پس در این مقاله نرخ و بازده کندوپاش به یک مفهوم به کار برده میشوند.
چه عواملی بر بازده کندوپاش تأثیر می گذارد؟
بازده کندوپاش تحت تأثیر عوامل زیر است:
- انرژی یون های برخوردی
- فشار گاز فرآیند کندوپاش
- ترکیب ماده هدف
- زاویه برخورد یونها
- ساختار کریستالی سطح هدف
تأثیر انرژی یونی بر بازده اسپاترینگ
بازده کندوپاش به عنوان تابعی از انرژی یونی در شکل ۲ نشان داده شده است. در انرژیهای بسیار کم، یونهای فرودی نمیتوانند اتمها را از سطح هدف جدا کنند، بنابراین هیچ بازده کندوپاشی وجود ندارد. فرآیند کندوپاش در انرژی آستانه آغاز میشود که برای اکثر مواد می تواند تا ۴۰ الکترونولت باشد و به عواملی همچون آلودگی سطح کاتد، زاویه برخورد یون ها و جهت گیری کریستالی ماده هدف بسیار حساس است.
در رژیم کندوپاش ضربهای، بازده کندوپاش وابستگی خطی به انرژی یون فرودی دارد (در منحنی تمام لگاریتمی).
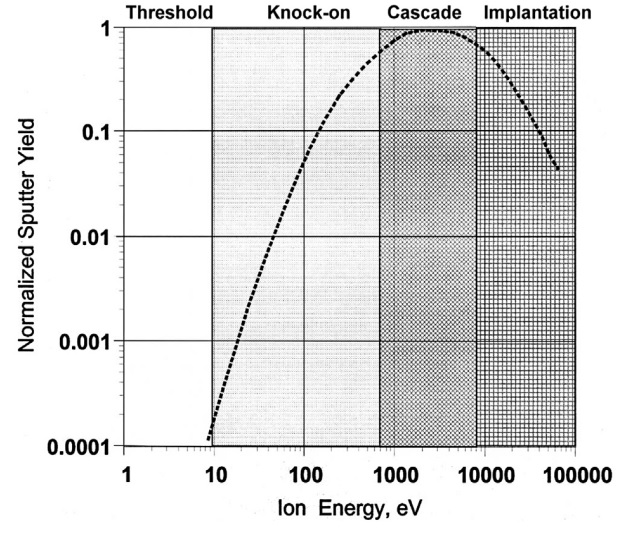
در ناحیه آبشاری، یونهای فرود آمده باعث ایجاد آبشاری از اتمهای هدف میشوند که پیوندهای آنها در یک حجم آبشاری شکسته میشود.
در انرژیهای یونی بالاتر، یونها به عمق مواد هدف نفوذ کرده و در آنجا کاشته میشوند و بازده کندوپاش را کاهش میدهند.
فشار گاز فرآیند کندوپاش
ترکیب مواد هدف
بازده کندوپاش اهداف مرکب با عناصر تشکیل دهنده آنها متفاوت است. در پژوهشی در مؤسسه ملی علوم مواد در ژاپن، اندازهگیری بازده کندوپاش عناصر خالص مانند Co، Cu، Ni، Ti و سیلیسیدهای آنها (سیلیسیدهای نیکل، کبالت و تیتانیوم) نشان میدهد که بازده کندوپاش سیلیسیدها را میتوان با ترکیب خطی بازده کندوپاشی عناصر تشکیل دهنده تخمین زد.
زاویه برخورد یونها
بازده کندوپاش به زاویه تابش یون نیز بستگی دارد. البته بستگی به این عامل به نوع ماده نیز مرتبط است. برای مثال، برای مواد با S کمتر (مانند Ta, Mo, Fe) در مقایسه با مواد با S بالاتر (مانند Au, Ag, Cu) این بستگی قویتر است.

اندازهگیری بازده کندوپاش
محاسبه نرخ کندوپاش به چندین روش انجام میشود. برخی از روشهای اندازهگیری نرخ کندوپاش شامل تکنیکهای زیر است:
- اندازهگیری کاهش وزن هدف با استفاده از حسگر کریستال کوارتز میکروبالانس (QCM) برای تشخیص تغییرات جزئی در جرم هدف.
- اندازهگیری کاهش ضخامت هدف با تکنیکهای آنالیز سطحی مانند SEM برای اندازهگیری تغییرات جزئی در ضخامت هدف
- تعیین تغییرات ترکیب سطحی توسط RBS در حین فرآیند کندوپاش با دقت حدود ۱۰%
- جمع آوری مواد پراکنده شده
- تشخیص ذرات پراکنده شده از هدف در محفظه
تقویت بازده کندوپاش
برای اهداف ساخته شده از عناصر سبک مانند کربن، انتقال تکانه کم است و آبشار برخورد ممکن است به توده (داخل) هدف گسترش یابد، بنابراین کندوپاش خیلی مؤثر نیست. در این موارد، تکنیک تقویت بازده کندوپاش به کمک اتمهای سنگینتر میتواند مؤثر باشد. در این روش، آبشار برخوردها با انعکاس توسط تکلایهای از اتمهای سنگینتر کاشته شده در زیر سطح هدف تقویت شده و بازده کندوپاش افزایش مییابد. برای مثال، با تعبیه یک لایه از اتمهای پلاتین در یک هدف کربنی موجب افزایش ۳ برابری بازده کندوپاش میشود.

چگونه کاتدهای مگنترون نرخ کندوپاش را افزایش میدهند؟
نرخ کندوپاش را میتوان با استفاده از کاتدهای مگنترون به طور قابل توجهی بهبود بخشید، بدین صورت که میدان مغناطیسی آهنرباهای کاتدی در پشت هدف، ذرات باردار پلاسما را در مسیرهای مارپیچ نزدیک به هدف به دام میاندازد. این چگالی افزایش یافته الکترونها در ناحیه نزدیک به هدف منجر به نرخ یونیزاسیون بالاتر میشود، بنابراین سرعت کندوپاش در فشار گاز فرآیند پایینتر افزایش مییابد.
نرخ کندوپاش به صورت خطی بر اساس تعداد آهنرباها افزایش مییابد. بنابراین، هنگامی که نرخ کندوپاش مطلوب با استفاده از حداکثر قدرت کندوپاش به دست نمیآید، افزایش تعداد آهنرباها میتواند راهگشا باشد.
نتیجه گیری
سرعت کندوپاش یا بازده کندوپاش یک عامل کلیدی در یک فرآیند پوششدهی کارآمد است و به پارامترهای مختلفی مانند ترکیب و ساختار ماده هدف، انرژی یون فرودی و زاویه تابش بستگی دارد. بازده کندوپاش یک هدف را میتوان از طریق روشهای مختلفی مانند کاشت تک لایهای از اتم های سنگین در زیر سطح هدف افزایش داد. همچنین نرخ اسپاترینگ یا استفاده از کاتدهای مگنترون تقویت میشود.
همه سیستمهای لایهنشانی اسپاترینگ شرکت پوششهای نانوساختار، مانند اسپاترکوترهای تک کاتده DSR1، DST1، یا اسپاترکوترهای چند کاتده خلاء بالا DST3 یا DST2-TG، برای افزایش سرعت کندوپاش اهداف مختلف با کاتدهای مگنترون ارائه میشوند.
برخی از دستگاههای لایه نشانی در خلاء ما
منابع
- Wasa, Kiyotaka. “Sputtering phenomena.” Handbook of Sputtering Technology (2012): 41-75.
- Bräuer, G. “Magnetron sputtering.” (2014).
- Sarkar, Jaydeep. “Sputtering and thin film deposition.” Sputtering Materials for VLSI and Thin Film Devices; Elsevier: Amsterdam, The Netherlands 2 (2014): 93-170.
- Yoshitake, Michiko, Yasuhiro Yamauchi, and Chandra Bose. “Sputtering rate measurements of some transition metal silicides and comparison with those of the elements.” Surface and Interface Analysis: An International Journal devoted to the development and application of techniques for the analysis of surfaces, interfaces and thin films 36.8 (2004): 801-804.
- Dawber, M. “Sputtering techniques for epitaxial growth of complex oxides.” Epitaxial Growth of Complex Metal Oxides. Woodhead Publishing, 2015. 37-51.
- https://www.lesker.com/newweb/ped/rateuniformity.cfm
- https://www.lesker.com/leskertech/archives/0g11m3h/leskertech_v7_i1.pdf
















